| Through-hole |
|
| FCCL 권장 자재 Spec. |
|
| Drill |
100㎛ : 1/30z 이하 권장 |
| 150㎛ : 1/20z 이하 권장 |
| Cu. Plating |
Min. 7㎛ 이상 |
| |
D/S |
Multi-Layer |
| A (최소직경) |
100㎛ |
200㎛ |
| B (최소직경) |
300㎛ |
400㎛ |
| C (최소직경) |
50㎛ |
60㎛ |
|
 |
|
 |
| Type별 Pattern Spec. |
|
| 구분 |
회로폭(L) |
회로간격(S) |
공차(G) |
| 단면 |
1/3 Oz |
40wm |
40㎛ |
15㎛ |
| 1/2 Oz |
50wm |
50㎛ |
15㎛ |
| 1 Oz |
60㎛ |
60㎛ |
15㎛ |
| 양면 |
1/3 Oz |
50㎛ |
50㎛ |
15㎛ |
| 1/2 Oz |
60㎛ |
60㎛ |
15㎛ |
| 1 Oz |
70㎛ |
70㎛ |
15㎛ |
| 다층 |
1/3 Oz |
60㎛ |
60㎛ |
20㎛ |
| 1/2 Oz |
80㎛ |
80㎛ |
20㎛ |
| 1 Oz |
100㎛ |
100㎛ |
20㎛ |
|
 |
|
 |
| Teardrop |
|
 |
|
- Line과 Pad를 보강하여 단선 방지
- Teardrop은 Via-land의 약 1.5배가 적당하며, 단자 두께의 약 1.5배가 적당하다
|
|
 |
| 절곡부 회로설계 |
|
 |
|
- 회로폭 감소부 또는 꺾이는 부분은 보강판 경계면을 Min. 500㎛이상 겹쳐 적응
|
|
 |
| 회로보정 |
|
- 에칭 작업 시 생성되는 회로폭은 등박의 두께만큼 감소 되므로 100㎛의 회로폭을 만족하기 위해서는,
사용되는 자재의 동박 두께만큼 회로폭을 더하여 회로를 설계하여야, 원하는 회로폭을 얻을 수 있다.
- 업체 제품 특성 및 제품 Type에 따라 보정치는 다르게 적응 될 수 있으며, 회로 공차등에 따라서도
차등 적용함.
|
 |
|
|
 |
| 외형과 Pattern의 간격 |
|
- 회로 및 GND등 제품 내부의 동박은 외형에서 0.2mm이상 이격시켜 형성되어야 함.
- 외형 Cutting시 등박이 노출되거나 회로가 인접한 경우 회로폭 감소 및 Short불량을
발생 시킬
수 있다.
|
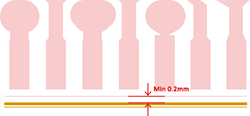 |
|
|
 |
| 기구홀과 Pattern의 간격 |
|
| 구분 |
공차 |
| Hole과 Pattern의 거리 |
200㎛ |
| Hole과 Dummy Pattern의 거리 |
200㎛ |
|
 |
|
|
 |
| CNT 부 회로공차 |
|
| 구분 |
공차 |
| A (회로대비 치우침) |
±50㎛ |
| B (회로간격) |
±30㎛ |
| C (회로간격누적) |
±50㎛ |
| D (CNT부 폭 공차) |
±100㎛ |
|
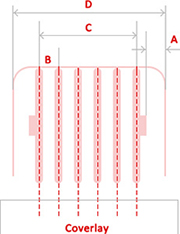 |
|
|
 |
| 회로대비 치우침 공차 |
|
| 구분 |
Cover-Lay |
Solder Resist |
| UV Ink |
P.S.R |
| 일반공차 |
±200㎛ |
±200㎛ |
±100㎛ |
| 특수사양 |
±100㎛ |
±200㎛ |
±50㎛ |
|
|
|
 |
| Stiffner 설계 |
|
 |
|
- Stiffner 영역은 Top면 Cover-Lay 영역보다, Min. 0.5mm 확장 설계하여 꺾임 및 단자 Crack을 방지함
|
|
 |
| Stiffner 부 기구홀 설계 |
|
| 구분 |
크기 및 거리 |
| A (Hole Size) |
Ø > 보강판 두께 |
| B (Outline 과의 거리) |
B > 보강판 두께
(Crack 및 백화현상 방지) |
|
 |
|
|
- Stiffner 영역은 Top면 Cover-Lay 영역보다, Min. 0.5mm 확장 설계하여 꺾임 및 단자 Crack을 방지함
|
|
 |
| Double Tape 부착 |
|
|
|
- Double Type의 부착은 외형라인 바깥으로 형성하여 외형가공 시 Cutting 하여야 라인의 마무리가 정확함.
|
|
 |
| Stiffner 및 D/T 치우침 공차 |
|
| 구분 |
Double Tape |
Stiffner |
| 일반 |
특수사양 |
| 허용공차 |
±100㎛ |
±200㎛ |
±100㎛ |
|
|
|
- Stiffner 및 Tape 부착은 수작업, 또는 JIG를 사용하여 ±200㎛으로 관리하며, 특수사양의 경우 설비를 사용하여 보다 정교한 공차로 작업 할 수 있음.
|
|
 |
| Silk부 설계 |
|
|
|
- Marking 인쇄의 공차는 ±200㎛으로 관리하며, 회로 또는 Cover-Lay경계면과의 이격 거리를 유지하여야 함.
|
|
 |
| Stiffner 및 D/T 치우침 공차 |
|
| 구분 |
Double Tape |
설계 |
| 금형 최소 R 값 |
 |
- 일반적으로 사용되는 와이어는 0.25Ø 홀 R.02로 가공
- 최소 R0.1 까지 구현 가능하나 와이어 수입으로 일정 및 가격 상승
|
| 기구홀 Size |
 |
- 기구홀의 경우 통상 Min. 0.5Ø 까지 가능 (부자재 없는 일반 사양)
- 제품 두께의 0.1T 증가시 홀 치수 0.1Ø 확대하여 진행
|
| C/L 최소 이격거리 |
 |
- C/L 최소 간격은 0.2mm 이며, 이하 Spec 진행 시 Open오로 진행 가능
- 이하 Spec 진행 시 금형 스크랩 도피부 금형 파손 발생
|
| 'U'자 홈 Spec. |
 |
- 'U'자 홈의 경우 Min. 0.5mm 까지 가능
- Burr 및 제품 형상을 원활하게 진행하기 위해선 1차 Piercing으로 진행
|
|
|
|
| |
|

